集成電路失效分析步驟:
1. 開封前檢查,外觀檢查,X光檢查,掃描聲學(xué)顯微鏡檢查。
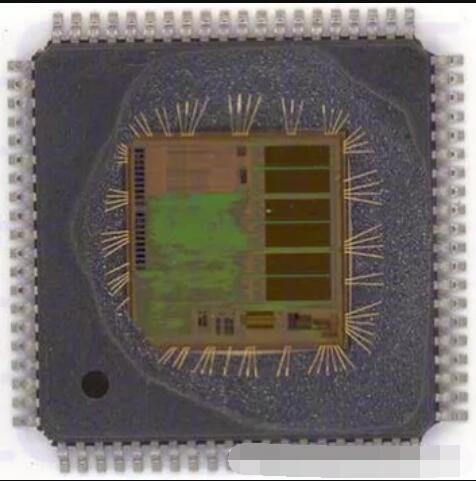
3. 電性能分析,缺陷定位技術(shù)、電路分析及微探針分析。
4. 物理分析,剝層、聚焦離子束(FIB),掃描電子顯微鏡(SEM),透射電子顯微鏡(SEM)、VC定位技術(shù)。
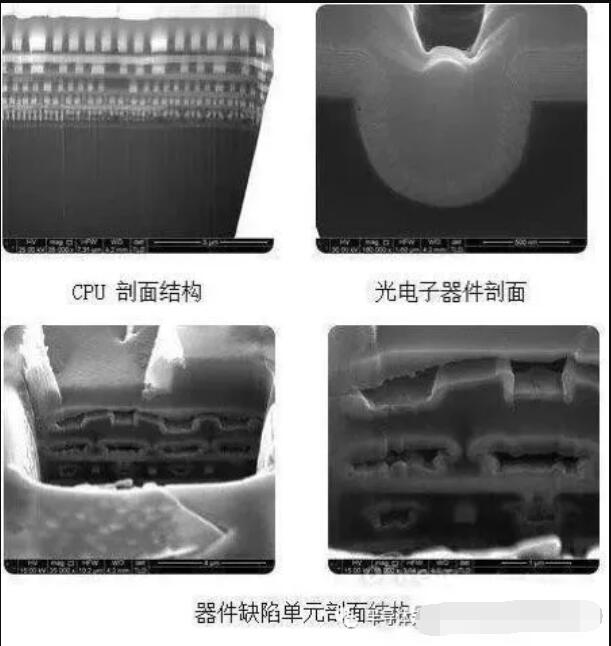
1.外觀檢查,主要憑借肉眼檢查是否有明顯缺陷,如塑脂封裝是否開裂,芯片引腳是否接觸良好。X射線檢查是利用X射線的透視性能對被測樣品進(jìn)行X射線照射,樣品缺陷部份會吸收X射線,導(dǎo)致X射線照射成像出現(xiàn)異常。X射線主要檢查集成電路引線是否損壞問題。根據(jù)電子元器件的大小和結(jié)構(gòu)選擇合適的波長,這樣能得到合適的分辨率。
2.掃描聲學(xué)顯微鏡,是利用超聲波探測樣品內(nèi)部缺陷,依據(jù)超聲波的反射找出樣品內(nèi)部缺陷所在位置,這種方法主要用主集成電路塑封時水氣或者高溫對器件的損壞,這種損壞常為裂縫或者脫層。
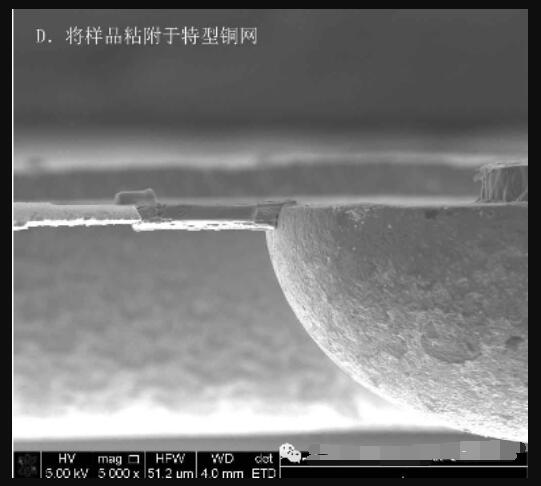
1. 打開封裝,一般有三種方法。全剝離法,集成電路完全損壞,只留下完整的芯片內(nèi)部電路。缺陷是由于內(nèi)部電路和引線全部被破壞,無法再進(jìn)行電動態(tài)分析 。方法二局總?cè)コǎ心C(jī)研磨集成電路表面的樹脂直到芯片。優(yōu)點是開封過種不損壞內(nèi)部電路和引線,開封后可以進(jìn)行電動態(tài)分析。方法三是自自動法用硫酸噴射達(dá)到局部去除的效果。2.缺陷定位,定位具體失效位置在集成電路失效分析中,是一個重要而困難的項目,缺陷定位后才能發(fā)現(xiàn)失效機(jī)理及缺陷特征。a.Emission顯微鏡技術(shù),具有非破壞性和快速精準(zhǔn)的特性。它使用光電子探測器來檢測產(chǎn)生光電效應(yīng)的區(qū)域。由于在硅片上產(chǎn)生缺陷的部位,通常會發(fā)生不斷增長的電子--空穴再結(jié)全而產(chǎn)生強烈的光子輻射。
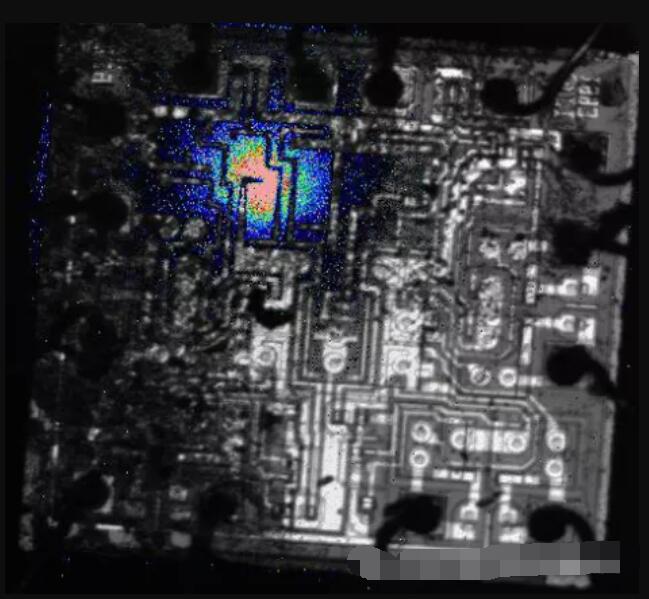
b. OBIRCH技術(shù)是利用激光束感應(yīng)材料電阻率變化的測試技術(shù)。對不同材料經(jīng)激光束掃描,可得到不同材料電阻率變化,這一方法可以測試金屬布線內(nèi)部的那些可靠性隱患。C.液晶熱點檢測一般由偏振顯微鏡,可調(diào)節(jié)溫度的樣品臺,以及控制電路構(gòu)成。在由晶體各向異性變?yōu)榫w各向同性時,所需要的臨界溫度能量很小,以此來提高靈敏度。同時相變溫度應(yīng)控制在30-90度,偏振顯微鏡要在正交偏振光的使用,這樣可以提高液晶相變反應(yīng)的靈敏度。
根據(jù)飾電路的版圖和原理圖,結(jié)合芯片失效現(xiàn)象,逐步縮小缺陷部位的電路范圍,最后利用微探針顯微技術(shù),來定位缺陷器件。微探針檢測技術(shù),微探針的作用是測量內(nèi)部器件上的電參數(shù)值,如工作點電壓、電流、伏安特性曲線。微探針技術(shù)一般伴隨電路分析配合使用,兩者可以較快地搜尋失效器件。

1. 聚焦離子束(FIB),由離子源,離子束聚焦和樣品臺組成。利用電鏡將離子聚焦成微波尺寸的切割器。聚焦離子束的細(xì)微精準(zhǔn)切割,結(jié)合掃描電鏡的高分辨率成像,可以很好地解決剖面問題,定位精度可以達(dá)到0.1um以下,同時剖面過程過集成電路愛到的應(yīng)力很小,完整地保存集成電路。2. 掃描電子顯微鏡(SEM),利用聚焦離子束轟擊器件面表,面產(chǎn)生許多電子信號,將這些電子信號放大作為調(diào)制信號,連接顯示器,可得到器件表面圖像。透射電子顯微鏡(TEM),分辨率可以達(dá)到0.1nm,透射電子顯微鏡可以清晰地分析器件缺陷,更好地滿足集成電器失效分析對檢測工具的解析要求。
3. VC定位技術(shù)基于SEM或FIB的一次電子束或離子束,在樣品表面進(jìn)行掃描。硅片表面不現(xiàn)部位有不同電勢,表現(xiàn)出來不同的明亮對比,找出導(dǎo)常亮的點從而定位失效點。
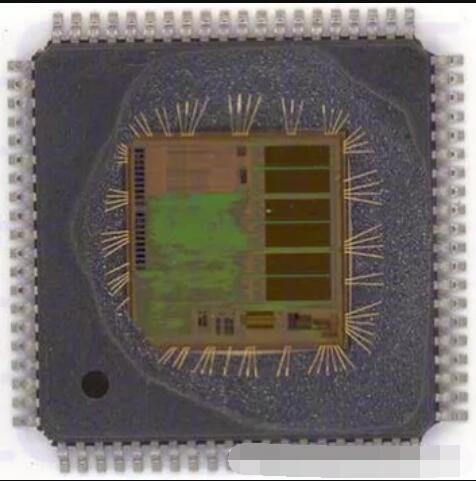
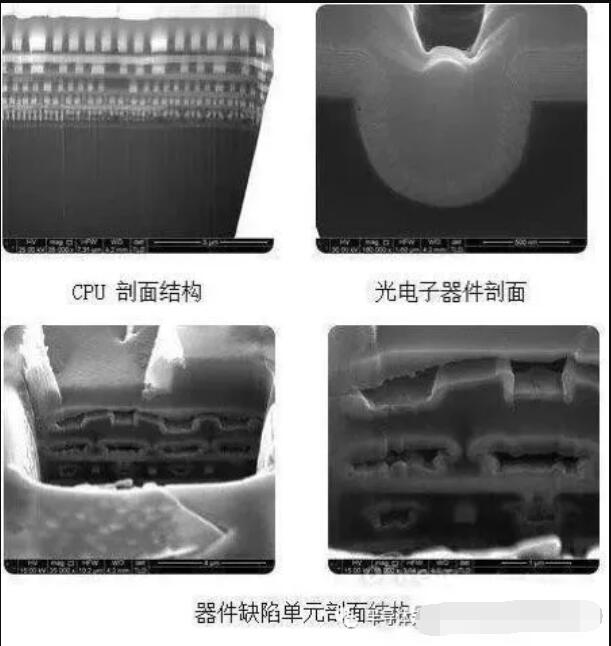
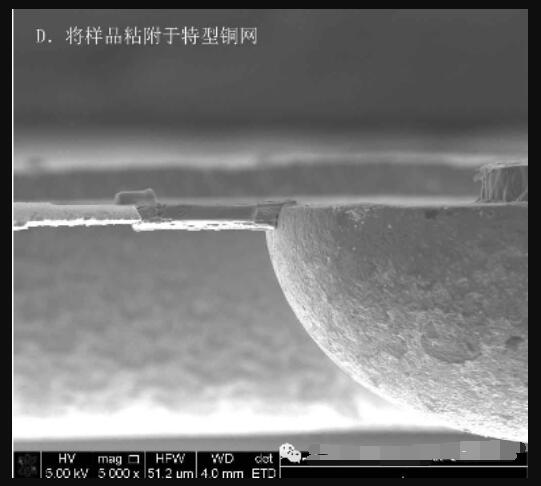
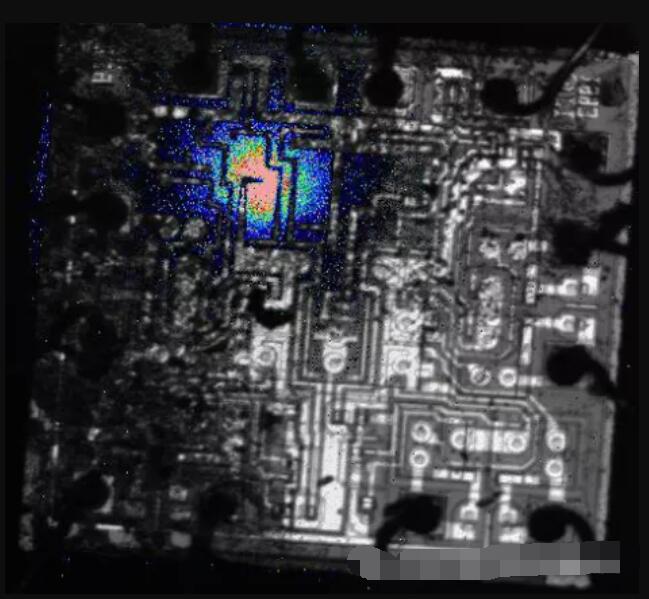

 新浪微博
新浪微博





